
领域分类:生物医学_药物分析_其他
检测项目:药物研发
二次离子质谱(SIMS)的表面分析和深度剖析
二次离子质谱SIMS是一种检测固体表面及近表面的成分信息的技术,几乎能够分析任何真空下稳定的固体,其不仅能够做到从H到U的全元素及同位素分析,同时还可以分析原子团和官能团,并可以对固体进行微区分析成像和深度动态剖析。当前,SIMS以其强大的功能和超高的分辨率和优异的检出限而被广泛应用于半导体、生物、医药、化学、材料、天体物理等研究领域。
其技术原理是利用一定能量(keV~MeV)的初级离子束入射到样品表面,其中一部分离子发生背散射被反弹出去,另一部分则进入样品内部,与样品表面粒子发生碰撞,当这些粒子达到溅射阈能时,即被溅射激发出去。其中少部分溅射的粒子带有正负电荷,这些粒子即二次离子,当这些二次离子进入到质量分析器被记录质荷比,即可得到样品信息。
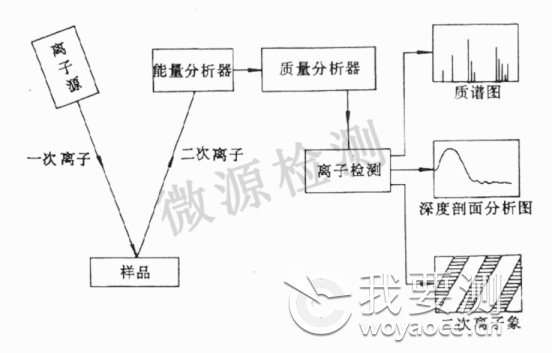
质谱图
SIMS中被溅射出去的粒子,可以时离子、团簇、或者分子结构,因此即可以用于分析无机物,也可以用于分析有机大分子。例如在半导体领域,SIMS可以用于动态深度剖析物体近表面的元素掺杂空间分布,来研究元素掺杂对电子元器件的影响,也可以用于静态分析电子元器件表面有机污染物的结构,这已经成为一种不可替代的技术手段。
如下图即为高分子有机材料膜层结构的动态深度剖析,样品有机团簇的深度分布情况和不同膜层厚度等信息一目了然。
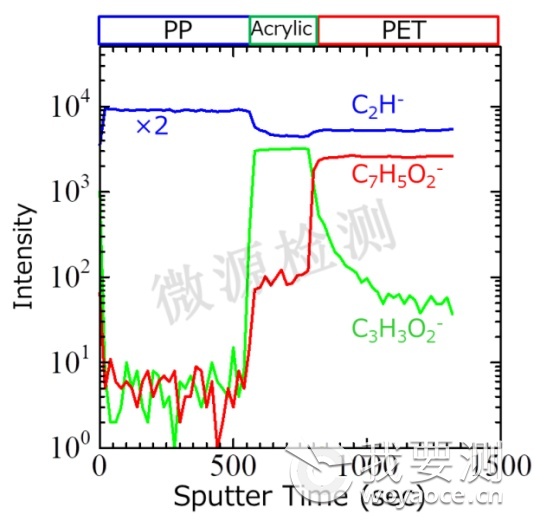
检测图
静态SIMS模式则是以较低离子束能量、束流密度,持续稳定的轰击材料表面,以此获得材料表面单层原子的元素信息。在静态SIMS中,配备TOF检测器是当前表面分析技术中分辨率和灵敏度最高的组合,TOF-SIMS的分辨率可以达到104,深度分辨率达到1nm,微区分辨率达到100nm2,二次离子浓度灵敏度达到ppm级别。杭州微源检测实验室可提供德国ION-TOF先进TOF-SIMS仪器检测,提供完善SIMS解决方案。下图为一种粉末发光材料在静态TOF-SIMS下扫描得到的元素、团簇质谱图及微区成像。

团簇质谱图
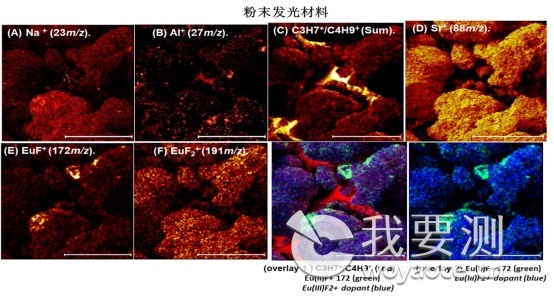
图像
二离子质谱(SIMS)的表面分析和深度剖析
| 产品名称 | 检测标准 | 检测项目 |
| SIMS测试 | GB/T 40129-2021 表面化学分析 二次离子质谱 飞行时间二次离子质谱仪质量标校准 | 表面分析和深度剖析 |
下一篇:未知杂质|溶剂残留|分离纯化
上一篇:消泡剂残留




